
Application de la technologie XRD dans l'industrie des semi-conducteurs
2023-09-20 10:00Les dépenses mondiales en équipements de semi-conducteurs sont entrées dans un cycle ascendant. L'application de nouvelles technologies et de nouveaux produits tels que la 5G, l'Internet des objets, le big data, l'intelligence artificielle et l'électronique automobile entraîneront une énorme demande sur le marché des semi-conducteurs, et l'industrie entrera dans un nouveau cycle de hausse. La production de plaquettes, la croissance épitaxiale, le conditionnement et l'intégration en amont de l'ensemble de la chaîne industrielle, ainsi que la qualité de ses processus et de ses produits sont directement liés aux applications industrielles en aval. Rigaku dispose d'un système complet d'équipements, tels queDiffraction des rayons X(XRD), fluorescence des rayons X (FRX), réflectomètre à rayons X (XRR) et topographie à rayons X (XRT), qui peuvent être appliqués à l'ensemble du processus, depuis la production de plaquettes jusqu'aux circuits intégrés, et peuvent mesurer de manière non destructive un certain nombre de paramètres clés du processus : tels que l'épaisseur , composition, rugosité, densité, porosité, ainsi questructure en cristalet des défauts de structure cristalline.
1. Dans la production de plaquettes, le nombre et le type de défauts affecteront grandement les étapes suivantes. L'imagerie topologique aux rayons X (XRT) permet d'observer clairement les défauts et les luxations à la surface de la plaquette (Figure 1). Aider les producteurs à améliorer le processus et à contrôler la qualité.
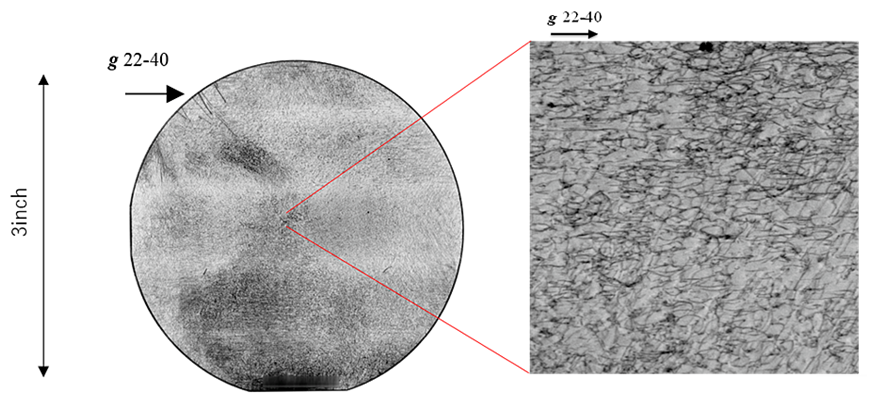
Figure 1 : Imagerie de topologie de transmission d'une plaquette 4H-sic
2. L'uniformité de la plaquette ou du film épitaxial peut être mesurée parDRXLa fonction de courbe d'oscillation et le module logiciel de visualisation fourni par Rigaku peuvent également donner des images de distribution bidimensionnelle, qui peuvent évaluer intuitivement la qualité de la surface (Figure 2).
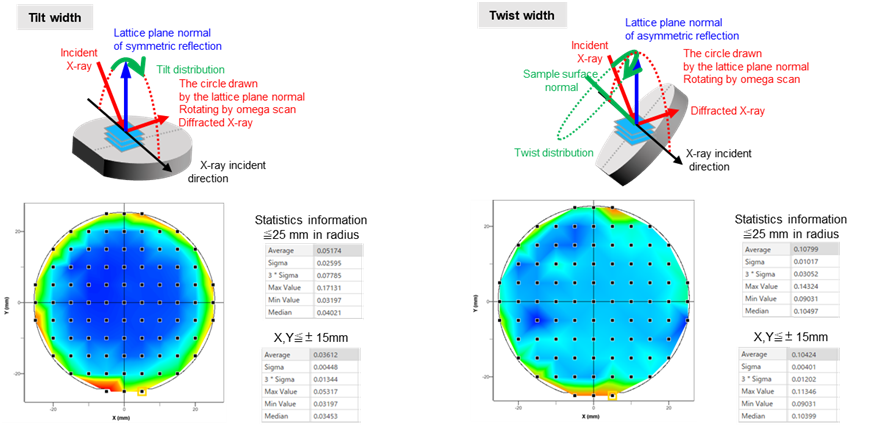
Figure 2 : Image bidimensionnelle d’un film d’AlN se développant sur un substrat saphir
3. L'épaisseur du film peut être mesurée par une courbe d'oscillation à haute résolution, non destructive et très précise (Figure 3).

Figure 3 : Courbe d'oscillation haute résolution pour mesurer l'épaisseur des films GaN/InxGa(1-x)N
4. Il peut y avoir une sorte de décalage de réseau pendant la croissance de la tranche ou du film épitaxial, ce qui affectera la qualité du film. Grâce aux détecteurs et solutions spéciaux de Rigaku, des tests spatiaux réciproques peuvent être effectués sur SmartLab, où les disparités de réseau etcristallographiqueles constantes peuvent être vues de manière très intuitive.
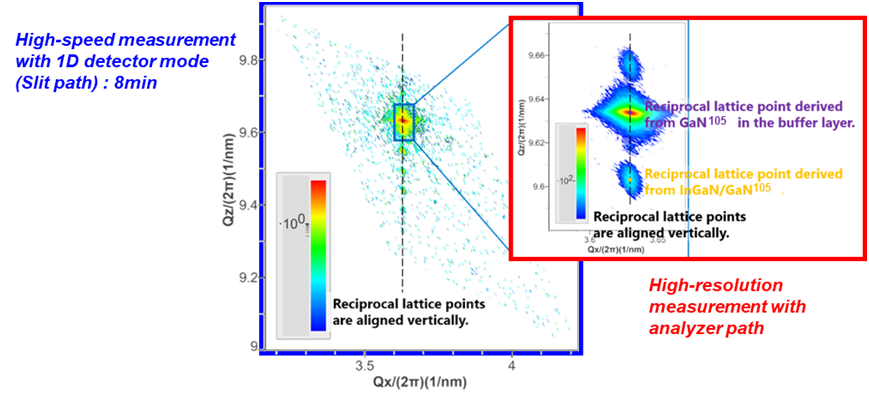
Figure 4 : spectre spatial réciproque haute résolution de GaN105
