
Mesures par diffraction des rayons X à haute résolution (HR-XRD) de semi-conducteurs composés
2023-09-16 10:00La XRD haute résolution (HR-XRD) est une méthode courante pour mesurer la composition et l'épaisseur de semi-conducteurs composés tels que SiGe, AlGaAs, InGaAs, etc.
Lorsque des dopants ou des impuretés sont ajoutés à unmonocristalréseau de manière par déplacement, le réseau se déformera en raison de la présence d'atomes dopants. Par exemple, dans un réseau Si, la présence d’atomes de Ge provoque une déformation en compression car les atomes de Ge sont plus gros que les atomes de Si dans le réseau. Cette déformation modifie l'espacement du réseau Si, et cette différence d'espacement peut être détectée par HR-XRD.

Figure 1 : Balayage théorique HR-XRD d'une structure générale sous contrainte de compression, telle qu'une couche de SiGe de 10 nm sur un substrat de Si. Les pointes à 0 degré proviennent du réseau Si du substrat.
La présence d'atomes de Ge plus gros entraîne un éloignement des atomes de Si dans la couche de SiGe, ce qui entraîne un déplacement du pic de diffraction vers un angle inférieur (à gauche du pic du substrat). Étant donné que la couche de SiGe de 10 nm est plus fine, le pic de diffraction de la couche de SiGe est beaucoup plus large que celui du substrat de Si.
Dans de tels films, seules quelques rangées d'atomes présentant un certain agencement peuvent être utilisées pour produire un signal de diffraction, et leDiffraction des rayons XLe pic est plus large que la diffraction à partir d’un substrat en Si, car il existe des milliers de rangées dans le substrat qui peuvent être utilisées pour produire la séquence atomique des signaux de diffraction. Si la structure est soumise à une contrainte de traction, les atomes de Si seront plus rapprochés que les atomes de Si dans le substrat et le pic de diffraction correspondant se déplacera vers la droite du pic du substrat. Les pics supplémentaires du spectre, appelés"des stries d'épaisseur,"proviennent d’une interférence accrue des rayons X réfléchis par l’interface entre la couche de SiGe et le substrat de Si. Il s'agit du même signal utilisé pour l'analyse de réflectance des rayons X (XRR) et peut être utilisé pour déterminer l'épaisseur de la couche de contrainte.
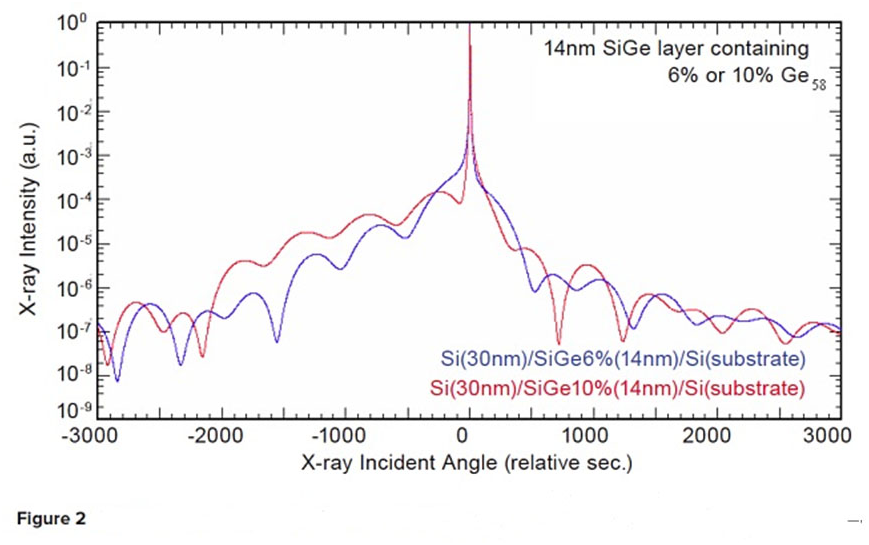
Cette méthode peut être utilisée pour déterminer la composition de la couche de contrainte. La figure 2 montre une analyse HR-XRD théorique de deux échantillons, cultivés à partir d'un Si de 30 nm sur un SiGe de 14 nm sur un substrat de Si. Dans le premier cas, il y a 6 % de Ge dans le réseau, tandis que dans l’autre cas, il y a 10 % de Ge. HR-XRD peut facilement faire la différence entre ces deux structures et déterminer l'épaisseur de la couche en fonction de la frange d'épaisseur.
De plus, des techniques de modélisation avancées permettent des descriptions précises des caractéristiques structurelles, telles que les couches de SiGe avec des structures graduées. HR-XRD peut mesurer une variété de matériaux épitaxiaux, tels que AlGaAs, InGaAs, InGaN, etc.DRXpeut déterminer la composition de ces couches de films minces avec une précision inférieure à 1 %. Cependant, il convient de noter que HR-XRD suppose que tous les atomes dopants sont présents dans le réseau.
